导 读 INTRODUCTION
封装是半导体制造过程的关键阶段,全球封装产业规模稳步提升。由于下游高端消费电子、人工智能、数据中心等快速发展的应用领域大量依赖先进封装,未来,先进封装增速预计将明显快于传统封装。据Yole,全球先进封装市场规模预计2028年达到786亿美元,2022-2028年CAGR为10.6%,远高于传统封装的3.2%,并将于2025年,首次超越传统封装,预计在全球封测市场占比达51%。
先进封装中,对“先进” 定义具有相对性:不同地区、不同时期对先进封装的定义不一样。一般来说,具备 Bump、RDL、 Wafer 和 TSV 四项基础要素中任意一种即可称为先进封装。先进封装材料包括临时键合材料、环氧塑封料、PSPI、底填胶、填料、湿电子化学品等。由于我国先进封装行业起步较晚,且先进封装材料普遍技术门槛高,大部分材料全球市场集中度较高,且主要由外资企业垄断。在全球集成电路、智能终端等产业产能加速向国内转移的背景下,叠加供应链安全、成本管控及技术支持等多方面因素考虑,先进封装材料国产替代进程有望加速。





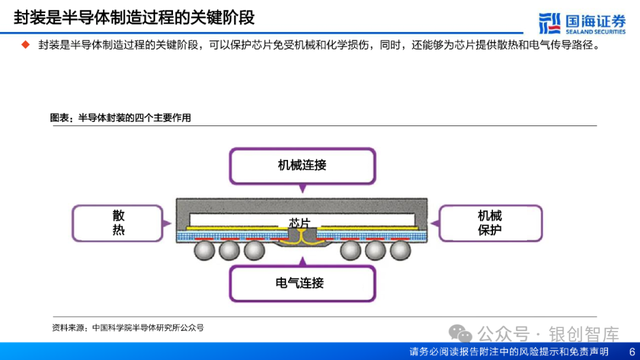




















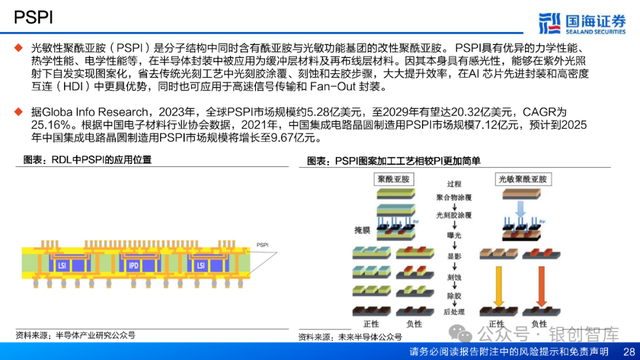














 精选报告来源:银创产业通
精选报告来源:银创产业通银创生态体系:银创报告库,银创社群圈,银创产业地产
聚焦领域:新能源/新材料/高端装备制造
核心主题:新质生产力丨储能丨锂电丨钠电丨动力电池丨燃料电池丨氢能源丨光伏丨风电丨新能源汽车丨电子元器件丨电机电控丨低空经济丨无人机丨机器人丨工业自动化丨人工智能丨能源金属丨碳中和丨半导体丨集成电路丨芯片丨光刻丨先进封装丨碳化硅丨湿电子化学品丨新材料丨超导材料丨稀土永磁材料丨碳纤维丨高分子